
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Omnino explicatio processus fabricandi chip (1/2): ab lagano ad packaging et probatio
2024-09-18
Fabricatio uniuscuiusque producti semiconductoris centenas processus requirit, et tota vestibulum processus in octo gradus dividitur;laganum processus - oxidatio - photolithographia - etching - tenuis summi membrana depositionis - connexio - probatio - packaging.
![]()
Gradus 1:Azymum processus
Omnes processus semiconductores cum grano harenae incipiunt! Quia Pii in arena contenta est materia rudis ad lagana producendum. Laganae crustae rotundae ex singulis cylindris cristalibus e siliconibus (Si) vel gallium arsenide secantur (GaAs). Ad summam puritatem extrahere materias Pii, harenam silicam, materiam specialem cum contento dioxide siliconis usque ad 95%, necessaria est, quae etiam praecipua est materia rudis ad lagana facienda. Processus lagani est processus faciendi supra laganum.
Ingot dejectio
Primum, arena calefieri debet ad monoxidum carbonis et pii in ea separandum, et iteratur processus usque ad gradum ultra-altae puritatis electronici Pii (EG-Si) obtinetur. Summus puritas pii in liquidum liquescit ac deinde solidatur in unam formam solidam crystalli, vocatam "ingot", quod est primus gradus in fabricandis semiconductoribus.
Praecisio ingotiorum siliconum (columnarum pii) valde alta est, ad gradum nanometri perveniens, et methodus late adhibita fabricandi methodus Czochralski est.
Ingot sectione
Post priorem gradum absolvitur, necesse est utrasque partes regulae cum serra adamantino abscindere et in tenues pecias cuiusdam crassitudinis secare. Diameter segmentum unctionis lagani magnitudinem determinat. Unitates laganae maiores et rariores dividi possunt in utibiles unitates, quae adiuvat ad costs productiones reducendas. Post incisum Pii incisum, necesse est notas "plani areae" seu "dent" in segmentis addere, ut faciliorem reddant directionem processus ut vexillum in gradibus subsequentibus.
Laganum superficies tincidunt
Crustae per processum incidendum consecuti vocantur "lagana nuda", id est, unprocessa "lagana cruda". Superficies lagani nudae inaequale est, et exemplar rotundum directe imprimi non potest. Ergo necesse est primo defectus superficies removere per stridorem et chemicorum etching processuum, deinde polire superficies lenis formare, et deinde contaminantes residuas removere per purgationem ad laganum confectum cum superficie munda obtinendum.
Gradus II: Oxidation
Munus processus oxidationis est ut velum tutelarium in superficie laganum formet. laganum ab immunditiis chemicis custodit, lacus venas ne intret, impedit diffusionem in implantatione ionae, et vetat laganum ne labi in engraving.
Primus processus oxidationis gradus est inquinamenta et contaminantes removere. Quattuor gradibus requirit ut materiam organicam, metallicam sordes et aquam residua exalant. Post purgationem, laganum in ambitu caliditatis 800 ad 1200 graduum Celsius collocari potest, et silicon dioxidum (i.e. "oxydatum") iacuit per fluxum oxygenii vel vaporis in superficie lagani formatum. Oxygenus per stratum oxydatum diffundit et cum pii reciproco ad formam oxydi straminis variae crassitudinis format, ejusque crassitudo post expletum oxidationem metiri potest.

Arida oxidatio et oxidatio humida Secundum diversum oxidantium in reactione oxidationis, processus scelerisque oxidationis dividi potest in oxidationis aridae et oxidationis humidae. Prior puro oxygenio utitur ad iacum dioxidum siliconis producendum, quod tardum est, sed stratum oxydatum tenue et densum est. Haec postulat tam oxygenium quam valde solutum vaporum aquaticum, quod proprium est celeri incrementi rate, sed relative densum stratum tutelae cum densitate humili.
Praeter oxidantum, aliae sunt variabiles quae crassitudinem iacuit dioxidis siliconis afficiunt. Primum, structura lagana, eius defectus superficies et defectus internae intentionis doping accidet ratem generationis oxydatum stratum. Praeterea, quo superior pressionis et temperatus ex instrumento oxidationis generatur, celerius iacuit oxydatum generabitur. In processu oxidationis, etiam opus est utere dummy scheda pro positione lagani in unitate ad tuendam laganum et differentiam in gradu oxidationis minuendam.
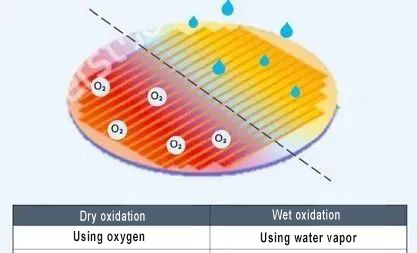
Gradus III: Photolithographia
Photolithographia est "pringere" exemplar ambitus super laganum per lucem. Intellegere possumus illam tabulam trahere ad planum semiconductorem in superficie lagani requisitum. Altior subtilitas circuitionis exemplaris, superior integratio spumae perfecti, quae perfici debet per technologiam photolithographiam provectam. Speciatim photolithographia in tres gradus dividi potest: photoresist efficiens, detectio et progressus.
Coating
Primus gradus ambitus in lagano ductus est, ut photoresist in strato oxydi loricatus. Photoresista laganum "charta photographica" facit mutando proprietates chemicae. Tenuior iacuit photoresista in superficie lagani, magis aequabilior tunica, et tenuior forma quae imprimi potest. Hic gradus potest fieri per modum "nent efficiens". Secundum differentiam reactivitatis lucis (ultraviolet) photoresistae in duas species dividi possunt: positivus et negativus. Illa dissoluet et evanescet post detectionem in lucem, relinquens exemplar areae inexpositae, haec vero post detectionem luci polymerizet et exemplar partis expositae apparebit.
Expositio
Post cinematographicum photographicum laganum opertum est, circuitus typographiae perfici potest moderato lumine expositionis. Hic processus appellatur "expositio". Lucem per expositionem apparatum selectas possumus transire. Cum lux per larvam in quo exemplar ambitus transit, circuitus imprimi potest in lagano cum pellicula photoresist obducta infra.
Per evulgationem processus, exemplar impressum subtilius, eo plura accommodare potest extremum chip, quod adiuvat ad efficientiam melioris productionis et sumptus uniuscuiusque partis reducendi. In hoc campo, nova technologia quae nunc multam attentionem trahens est EUV lithographia est. Lam Research Group coniunctim novam technologiam cinematographicam aridam cinematographicam cum opportunis sociis ASML et imec amplificavit. Haec technologia multum emendare potest productivity et cedere in EUV lithographiae expositionis processum per solutionem melioris (clavis factor in latitudine ambitus subtiliter-tuning).
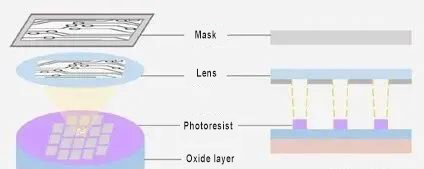
Progressus
Gradus post detectio elit in laganum spargit, propositum est photoresistam in area exemplaris detecto amoliri, ut exemplar circuitus impressus aperiri possit. Post evolutionem peractam variis instrumentis metiendis et microscopiis opticis cohibendus est, ut qualitas circuli schematis in tuto collocetur.
Gradus IV: Etching
Postquam photolithographiae ambitus diagramma completur in lagano, processus etching usus est ad cinematographicum oxydatum tollendum et solum semiconductorem circuii solum relinquat. Ad hoc liquidum, gas vel plasma, ad partes excessus delectas removendas adhibetur. Duae praecipuae methodi engraving, secundum substantias adhibitas: humidum etching utentes solutione chemica specifica ad chemicum reflecti ad removendum cinematographicum oxydatum, et utens gas vel plasma siccum etching.
infectum etching
Infectum adstringens solutiones chemicas ad tollendas cinematographicas oxydatum commoda commoda habet humilis sumptus, celeritas ieiunium etingens et productivitatem altam. Humidum autem engraving est isotropica, id est, quaquaversum eadem est celeritas. Hoc facit larva (vel cinematographica sensitiva) ut cum oxydorum cinematographico signato non perfecte perpendatur, ita difficile est pulcherrimo ambitu schematis procedere.

arida Etching
Sicca engraving potest dividi in tria genera. Prima est chemicae engraving, qua utitur vaporibus etching (maxime hydrogenii fluoride). Sicut humidum engraving, haec methodus isotropica est, quae significat non idoneam ad bene engraving.
Secundus modus est putris physici, qui utitur ionibus in plasmate ad impactionem et iacuit oxydatum excessum removendum. Ut methodus anisotropica etching, putris etching varias rates in directionibus horizontalibus et verticalibus habet, ita eius subtilitas etiam melior est quam chemica engraving. Autem, incommodum huius methodi est quod etching velocitas tarde est quia omnino nititur in reactione physica per ion collisionem causata.
Tertius modus ultimus est reciprocus ion etching (RIE). RIE duos primos modos coniungit, id est, cum plasma ad ionizationem physicam etching, chemica etching ope liberae radicalis post plasma activationis generatae generantur. Praeter celeritatem etchingum duos primos modos excedentes, RIE notis anisotropicis ionum uti potest ad exemplar summus praecisionem etching.
Hodie, arida engraving late adhibita est ut fructus optimorum ambitus semiconductoris emendare possit. laganum plenae etingificationis uniformitatis et crescentis celeritatis enodationis criticae sunt, et hodierno instrumento antecedens siccus etingens adiuvat productionem antecedens logicae et memoriae astulae cum altioribus effectibus.

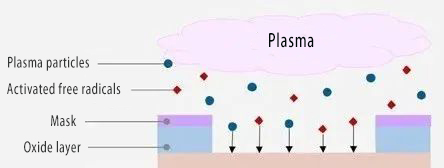
VeTek Semiconductor est professionalis Seres fabrica ofTantalum Carbide Coating, Pii Carbide Coating, Specialis Graphite, Pii Carbide CeramicsetAlia Semiconductor Ceramics. VeTek Semiconductor committitur ut solutiones provectae pro variis products SiC Wafer pro semiconductori industria committatur.
Si interesse in productis supradictis, placet liberum contactus nos directe.
Mob: +86-180 6922 0752
WhatsAPP: +86 180 6922 0752
Inscriptio: anny@veteksemi.com




