
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Applicatio TaC-Coated Graphite Partibus in Singulis Crystal Furnaces
2024-07-05
Applicationem of *TaC-Coated Graphite Partibusin Single Crystal Furnaces
PARS I
In incremento SiC et AlN singulae crystallis utentes modum onerarii physici vaporum (PVT) methodi cruciales, qualia sunt uasculum, semen possessor et anulus ductor munus vitale exercent. Depingitur in Figura 2 [1], durante processu PVT, semen crystallum in regione temperatura inferiore collocatur, dum Materia rudis SiC superioribus temperaturis obnoxia est (supra 2400 ℃). Hoc ducit ad compositionem materiae rudis, composita SiXCy producens (praesertim Si, SiC₂, Si₂C, etc.). Vapor Phase materia tunc a regione calidissima ad semen cristallum in regione inferiori temperatura transfertur, inde in formatione seminis nuclei, incrementi crystallini, et generatio simplicium crystallorum. Ergo materia scelerisque agri in hoc processu adhibita, ut uasculum, fluere rector anulus, et semen crystalli possessor, necesse est ut summus temperatus resistentiam sine contagione materiae rudis SiC et una crystallis. Similiter elementa calefactoria in AlN augmento crystalli adhibita Al vapori et N₂ corrosioni resistere debent, dum etiam altam eutecticam temperiem (cum AlN) habent, ut tempus praeparationis crystalli minuat.
Observatum est, adhibitis graphite graphite thermas utentes materiae campi ad parandum SiC [2-5] et AlN [2-3] proventum in mundioribus productis cum carbonis minimis (oxygeni, nitrogeni), aliisque inquinamentis. Hae materiae pauciores defectus in margine exhibent et in unaquaque regione resistentiam inferiorem. Accedit densitas microporarum et fovearum (post KOH etching) signanter reducta, ducens ad emendationem substantialem in qualitate crystalli. Praeterea TaC uasculum demonstrat paene nullum pondus damnum, speciem non perniciosam conservat et REDIVIVUS potest (cum vita ad 200 horas), ita ut sustineri et efficaciam unius cristalli processuum praeparationis augere.
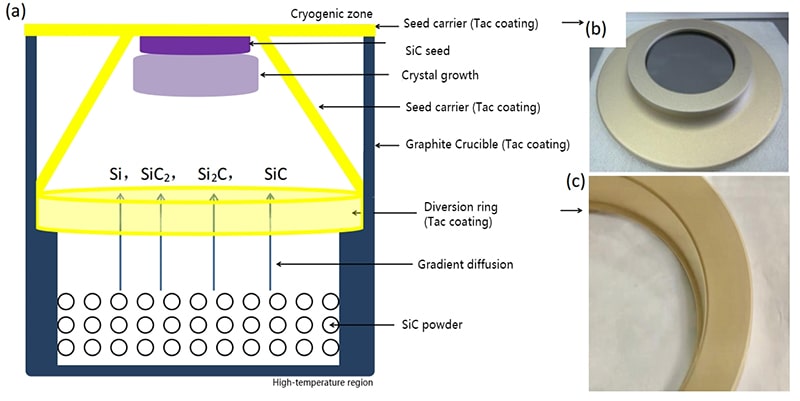
Fig. 2. (a) Schematica schematismi SiC singularis regulae crystalli crescentis fabrica per modum PVT
(b) Top TaC iactaret semen bracket (including semen SiC)
(c) TAC-coated graphite guide anulus
MOCVD GaN Epitaxial Layer Incrementum Heater
PARS II
In agro MOCVD (Metal-organico Depositio chemical Vapor) GaN incrementum, technica crucialis vaporis epitaxialis incrementi tenuium membranarum per motus organometallicas compositionis, calefaciens munus vitalem agit in assequendis moderatis temperatura et uniformitate in cubiculi reactionis. Sicut illustratur in Figura 3 (a), calefacientis nucleus instrumenti MOCVD consideratur. Facultas eius celerius et uniformiter calefacere subiectam per periodos extensos (inclusis repetitis cyclis refrigerantibus), altas temperaturas resistens (gas corrosio resistens), et cinematographici castitatem directe impingit qualitatem depositionis cinematographicae, crassitudinis constantiae, et effectus chippis.
Ad augendam efficientiam et redivivam calentium efficientiam in systematis MOCVD GaN incrementi, introductio graphite calentium TaC iactata est felix. Contra calefactores conventionales quae pBN (pyrolyticis boron nitride utuntur) coatingunt, gaN strata epitaxialia creverunt, calentium TaC utentes structuras cristallinas fere easdem exhibent, crassitudinem uniformitatem, defectionem intrinsecam formationis, immunditiam dopingem, et contaminationem gradus. Praeterea, TaC coating demonstrat humilis resistivity et emissio superficies humilis, consequens in meliori calefacientis efficientiam et uniformitatem, per reductionem potentiae consumptionis et caloris amissionem. Per processum parametri moderando, porositas liturae adaptari potest ad notas ulteriores calefacientis radiorum augendas et ad eius spatium vitae extendendum [5]. Haec commoda calentium graphitarum graphitarum optimam electionem pro MOCVD GaN systematis incrementi optimam stabiliunt.
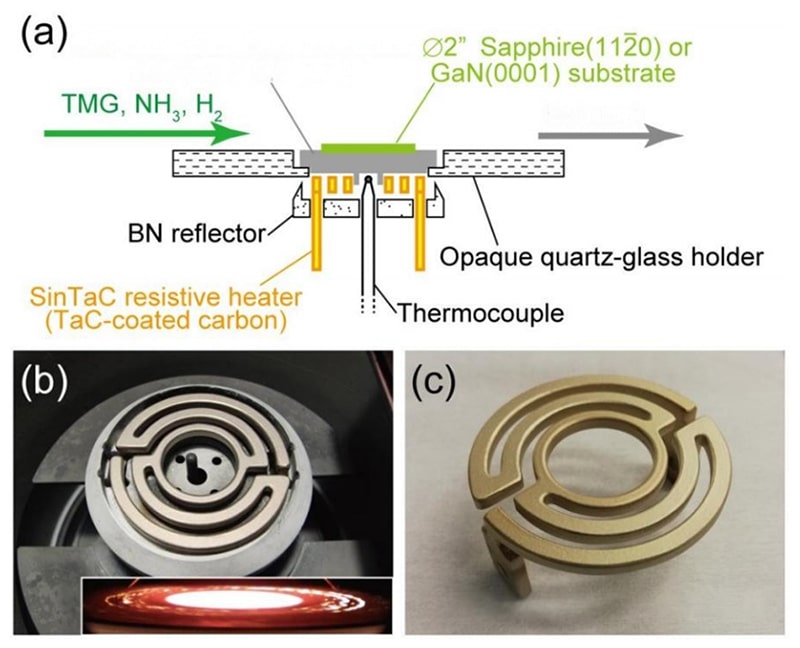
Fig. 3. (a) Schematica schematismi MOCVD fabrica ad incrementum epitaxial GaN
(b) Formata TAC graphite calefacientis inaugurata in MOCVD setup, excluso basi et bracket (ostensam monstrans basim et bracket in calefaciendo)
(c) TAC graphite calefacientis post 17 GaN epitaxial incrementum.
Coated Susceptor pro Epitaxy (Wafer Portitorem)
PARS / 3
Tabellula laganum, pars structuralis crucialis adhibita in confectione semiconductoris laganae tertii ordinis, ut SiC, AlN, et GaN, munus vitale agit in processibus lagani epitaxialis incrementi. Typice e graphite factum, tabellarius laganum SiC obductis ad resistendum corrosioni a gasorum processuum intra epitaxialem temperierum amplitudinem 1100 ad 1600 °C. Corrosio resistentia tunicae tutelae significanter impactus est laganum ferebat. Eventus experimentales docuerunt TaC ratem corrosionis exhibere circa 6 tempora tardius quam SiC cum ammoniae summus temperaturae expositae. In ambitibus hydrogenii summus temperatus, corrosio rate of TaC est vel plus quam X temporibus tardior quam SiC.
Probationes experimentales demonstravit fercula cum TaC obducta exhibeant optimam convenientiam in luce caerulea GaN MOCVD processus sine sordibus introducendis. Cum limitata compositione processum, LEDs creverunt utentes vehicularibus TaC demonstrant comparabilem observantiam et uniformitatem illis proventibus utentes portatores conventionales SiC. Quocirca servitium vitae vehicularum lagani TaC lagani superat quod graphitarum tunicarum et graphitarum SiC iactaret.
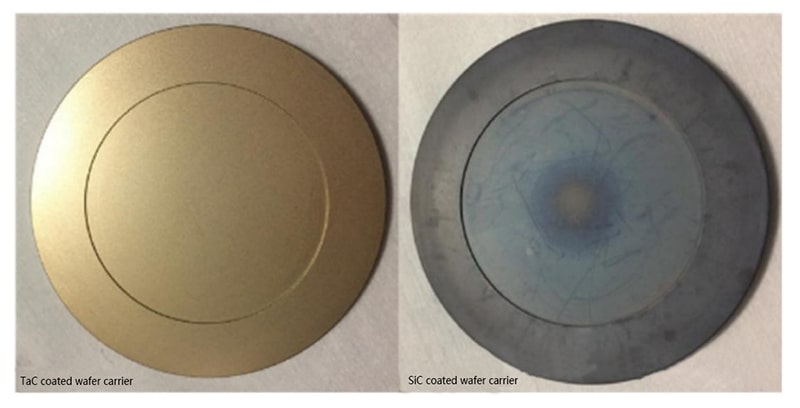
Figura. Ipsumque laganum usus post epitaxialem in GaN crevit MOCVD fabrica (Veeco P75). Alter a sinistris obducitur TaC, alter a dextra obducitur SiC.
Praeparatio communisTaC graphite iactaret partes
PARS I
CVD (Depositio Vaporis chemica) methodus;
Ad 900-2300℃, TaCl5 et CnHm utentes fontes in tantalum et carbonum, H₂ ut atmosphaeram minuentes, Ar₂as gasi tabellarius, motus depositionis cinematographici. Parata vestis est compacta, puritas uniformis et alta. Sed quaedam problemata sunt ut processus varios, sumptus sumptuosos, difficiles airflow imperium et efficientiam depositionis humilem.
PARS II
Slurry syntering method:
Slurry, fons carbonis continens, fons tantalum, dispersus et ligans graphite obductis et sinteratus in caliditate siccitate. Parata coatingis sine iusta intentione crescit, humilis sumptus habet et ad magnarum rerum productionem apta est. Reliquum est ut explorandum ad consequendam aequabilitatem plenamque in magnis graphitis efficiendis, defectibus subsidiis tollendis et vi compaginationis augendae.
PARS / 3
Modus plasma spargit;
TaC pulveris a plasmate arcus caliditatis caliditatis liquescit, in guttae caliditatis in caliditate summa celeritate gagates atomis, et in superficiei materiae graphite spargitur. Facile est accumsan oxydatum formare sub vacuo non-, et vis magna consumptio.
TaC iactaret partes graphite solvendas necesse est
PARS I
Vis obligandi:
Sceleris dilatatio coefficiens et aliae physicae proprietates inter TaC et carbonem materias diversae sunt, compages vis efficiens est humilis, difficile est vitare rimas, poros et accentus scelerisque, et litura facile est decerpere in ipsa atmosphaera quae putrescat ac saepe ortu et infrigidando processum.
PARS II
Puritas:
TaC coating necessitatem esse puritatem ultra altam ad vitandas immunditias et pollutiones sub caliditatis conditionibus, et efficacia signa et characterizationis contenta signa gratuiti carbonis et immunditiae intrinsecae in superficie et intus plenae vestitionis necessitatem esse constat.
PARS / 3
Stabilitas:
Temperatura resistentia et resistentia atmosphaerae chemicae supra 2300℃ sunt potissima indicia ad probandum stabilitatem efficiendi. Pinholes, rimas, angulos absentes, et limites frumenti unius orientationis facile sunt efficere ut vapores exedentes in graphite penetrarent et penetrarent, inde in defectum tutelae efficiens.
PARS / 4
Repugnantia oxidatio;
TaC oxidificare incipit ad Ta2O5 cum supra 500℃ est, et rate oxidatio auget cum augmento caliditatis et defectus oxygeni. Superficies oxidatio incipit ab terminis granis et granis parvis, et paulatim crystallis columnaribus et crystallis fractis format, inde in magno numero hiatus et foraminum, et dolor infiltration exasperatur usque dum litura exspoliatur. Proveniens iacuit oxydatum scelerisque conductivity pauper et varietate colorum in specie.
PART/V
Uniformitas et asperitas;
Inaequalis distributio superficiei coating potest ad intentionem accentus localem scelerisque ducere, periculum creptionis et spalling augere. Praeterea asperitas superficies commercium inter tunicam et ambitum externum directe afficit, et asperitas nimis alta facile auget frictionem cum lagano et agro inaequabili.
PARS/6
Magnitudo frumenti:
Uniformis grani magnitudo stabilitatem liturae adiuvat. Si granorum magnitudo parva est, vinculum non est strictum, et facile est oxidized et exedri, unde in magna multitudine rimas et foramina frumenti in ore, quod tutelam efficiendi tunicam minuit. Si granorum magnitudo nimis magna est, relative aspera est, et litura facile dilaniatur sub lacus scelerisque.
Conclusio et prospectus
In genere,TaC graphite iactaret partesin foro ingens postulatio et amplis prospectibus applicatio, hodiernaTaC graphite iactaret partesvestibulum amet est CVD TaC tium niti. Nihilominus, ob magnum apparatum productionis TaC CVD sumptus et efficientiam depositionis limitatam, traditae SiC materiae graphitae obductae omnino non sunt repositae. Methodus synteringis sumptus rudium materiarum efficaciter minuere potest et multiplicibus formis graphitarum partium accommodare, ut necessitates diversarum applicationis missionum occurrerent.



